Tiny Chiplets Enabled by Packaging Scaling: Opportunities in ESD Protection and Signal Integrity
By Emad Haque 1, Pragnya Sudershan Nalla 2, Jeff Zhang 1, Sachin S. Sapatnekar 2, Chaitali Chakrabarti 1 and Yu Cao 2
1 School of Electrical, Computer and Energy Engineering, Arizona State University, Tempe, AZ 85282, USA
2 Department of Electrical and Computer Engineering, University of Minnesota, Minneapolis, MN 55455, USA
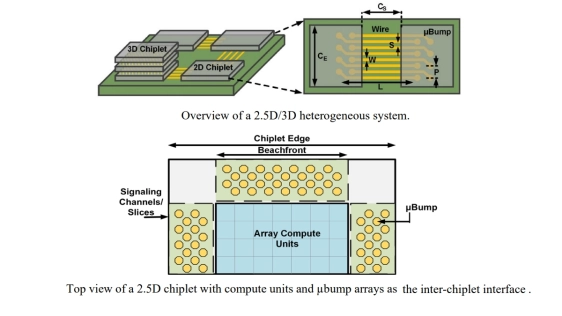
Abstract
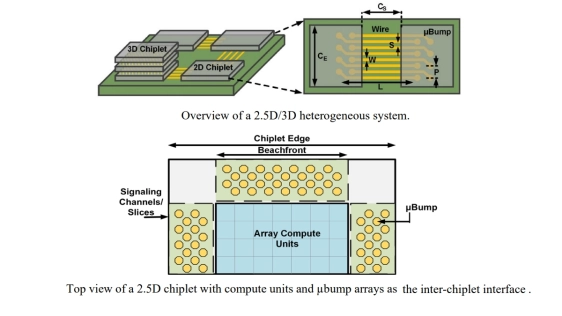 The scaling of advanced packaging technologies provides abundant interconnection resources for 2.5D/3D heterogeneous integration (HI), thereby enabling the construction of larger-scale VLSI systems with higher energy efficiency in data movement. However, conventional I/O circuitry, including electrostatic discharge (ESD) protection and signaling, introduces significant area overhead. Prior studies have identified this overhead as a major constraint in reducing chiplet size below 100 mm2. In this study, we revisit reliability requirements from the perspective of chiplet interface design. Through parasitic extraction and SPICE simulations, we demonstrate that ESD protection and inter-chiplet signaling can be substantially simplified in future 2.5D/3D packaging technologies. Such simplification, in turn, paves the road for further chiplet miniaturization and improves the composability and reusability of tiny chiplets.
The scaling of advanced packaging technologies provides abundant interconnection resources for 2.5D/3D heterogeneous integration (HI), thereby enabling the construction of larger-scale VLSI systems with higher energy efficiency in data movement. However, conventional I/O circuitry, including electrostatic discharge (ESD) protection and signaling, introduces significant area overhead. Prior studies have identified this overhead as a major constraint in reducing chiplet size below 100 mm2. In this study, we revisit reliability requirements from the perspective of chiplet interface design. Through parasitic extraction and SPICE simulations, we demonstrate that ESD protection and inter-chiplet signaling can be substantially simplified in future 2.5D/3D packaging technologies. Such simplification, in turn, paves the road for further chiplet miniaturization and improves the composability and reusability of tiny chiplets.
To read the full article, click here
Related Chiplet
- DPIQ Tx PICs
- IMDD Tx PICs
- Near-Packaged Optics (NPO) Chiplet Solution
- High Performance Droplet
- Interconnect Chiplet
Related Technical Papers
- Signal Integrity Challenges in Chiplet-Based Designs: Addressing Performance and Security
- Recent Progress in Structural Integrity Evaluation of Microelectronic Packaging Using Scanning Acoustic Microscopy (SAM): A Review
- A physics-constrained and data-driven approach for thermal field inversion in chiplet-based packaging
- Toward Digital Twins in 3D IC Packaging: A Critical Review of Physics, Data, and Hybrid Architectures
Latest Technical Papers
- A Review of Multiscale Thermal Modeling in Heterogeneous 3D ICs
- Spying Across Chiplets: Side-Channel Attacks in 2.5/3D Integrated Systems
- Affinity Tailor: Dynamic Locality-Aware Scheduling at Scale
- AMMA: A Multi-Chiplet Memory-Centric Architecture for Low-Latency 1M Context Attention Serving
- Exploring the Efficiency of 3D-Stacked AI Chip Architecture for LLM Inference with Voxel