Quantum Dot DBR Lasers Monolithically Integrated on Silicon Photonics by In-Pocket Heteroepitaxy
By Rosalyn Koscica 1, Alec Skipper 1, Bei Shi 1, Kaiyin Feng 1, Gerald Leake 2 and Michael Zylstra 3
1 University of California, USA
2 RF SUNY Polytechnic Institute, USA
3 Analog Photonics, USA
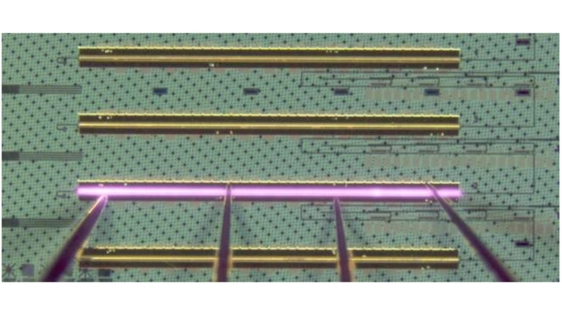
Abstract:
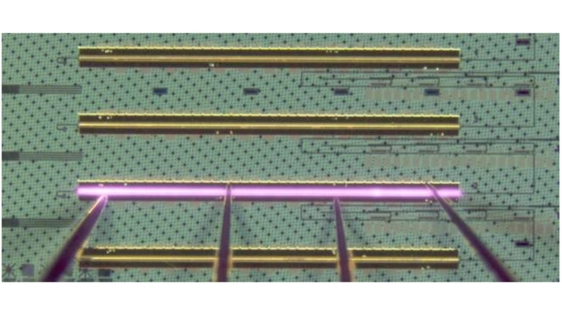 Monolithically integrated lasers on silicon photonics enable scalable, foundry-compatible production for data communications applications. However, material mismatches in heteroepitaxial systems and high coupling losses pose challenges for III-V integration on silicon. We combine three techniques: recessed silicon pockets for III-V growth, two-step heteroepitaxy using both MOCVD and MBE, and a polymer facet gap-fill approach to develop O-band InAs quantum dot lasers monolithically integrated on silicon photonics chiplets. Lasers coupled to silicon ring resonators and silicon nitride distributed Bragg reflectors (DBR) demonstrate single-mode lasing with side-mode suppression ratio up to 32 dB. Devices lase at temperatures up to 105 °C with an extrapolated operational lifetime of 6.2 years at 35 °C.
Monolithically integrated lasers on silicon photonics enable scalable, foundry-compatible production for data communications applications. However, material mismatches in heteroepitaxial systems and high coupling losses pose challenges for III-V integration on silicon. We combine three techniques: recessed silicon pockets for III-V growth, two-step heteroepitaxy using both MOCVD and MBE, and a polymer facet gap-fill approach to develop O-band InAs quantum dot lasers monolithically integrated on silicon photonics chiplets. Lasers coupled to silicon ring resonators and silicon nitride distributed Bragg reflectors (DBR) demonstrate single-mode lasing with side-mode suppression ratio up to 32 dB. Devices lase at temperatures up to 105 °C with an extrapolated operational lifetime of 6.2 years at 35 °C.
Index Terms—Active-passive coupling, DBR laser, III-V on Si integration, monolithic integration, optical coupling, O-band, quantum dot laser, semiconductor laser, silicon photonics.
To read the full article, click here
Related Chiplet
- DPIQ Tx PICs
- IMDD Tx PICs
- Near-Packaged Optics (NPO) Chiplet Solution
- High Performance Droplet
- Interconnect Chiplet
Related Technical Papers
- The Evolution of Photonic Integrated Circuits and Silicon Photonics
- Monolithically Integrated Optical Through-Silicon Waveguides for 3D Chip-to-Chip Photonic Interconnects
- Foundry-Enabled Patterning of Diamond Quantum Microchiplets for Scalable Quantum Photonics
- Interfacing silicon photonics for high-density co-packaged optics
Latest Technical Papers
- A Review of Multiscale Thermal Modeling in Heterogeneous 3D ICs
- Spying Across Chiplets: Side-Channel Attacks in 2.5/3D Integrated Systems
- Affinity Tailor: Dynamic Locality-Aware Scheduling at Scale
- AMMA: A Multi-Chiplet Memory-Centric Architecture for Low-Latency 1M Context Attention Serving
- Exploring the Efficiency of 3D-Stacked AI Chip Architecture for LLM Inference with Voxel