Intel’s Embarrassment of Riches: Advanced Packaging
By Alan Patterson, EETimes | March 27, 2025
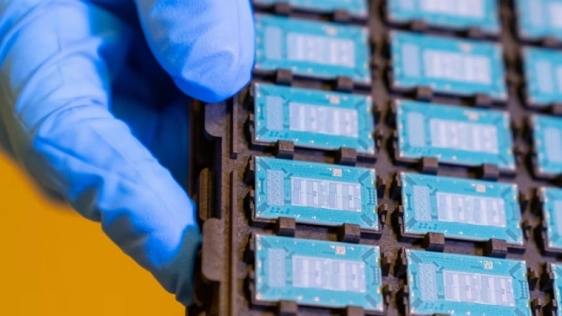
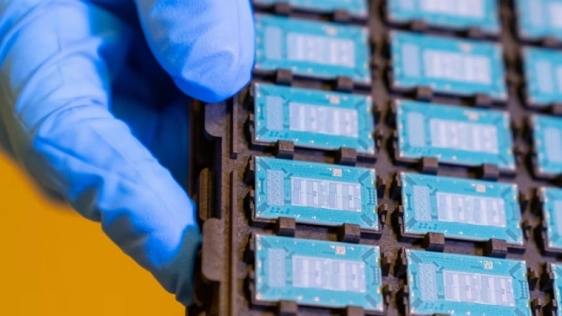 Intel Foundry has an embarrassment of riches: amid a shortage of advanced-packaging capacity, the company has excess supply.
Intel Foundry has an embarrassment of riches: amid a shortage of advanced-packaging capacity, the company has excess supply.
The manufacturing unit of the largest U.S. chip company is welcoming TSMC customers to transfer their designs directly from TSMC’s CoWoS to Intel’s Foveros advanced packaging. Demand for 3D wafer-level packaging from Nvidia and a handful of companies making AI chips has exceeded the ability of top foundry TSMC to meet demand since last year.
Intel has built the capacity, but few have come so far because the company has not been promoting it, TechInsights vice chair Dan Hutcheson told EE Times.
To read the full article, click here
Related Chiplet
- DPIQ Tx PICs
- IMDD Tx PICs
- Near-Packaged Optics (NPO) Chiplet Solution
- High Performance Droplet
- Interconnect Chiplet
Related News
- Siemens and Intel Foundry advance their collaboration to enable cutting-edge integrated circuits and advanced packaging solutions for 2D and 3D IC
- Glass Core Substrates and Interposers for Advanced Packaging: Insights from the Intellectual Property Landscape
- After TSMC fab in Japan, advanced packaging facility is next
- The Era of Heterogeneous Integration Approaches: Who Shall Dominate the Advanced Packaging Field?
Latest News
- CEA-Leti, CEA-List and PSMC Collaborate to Integrate RISC-V and MicroLED Silicon Photonics into 3D Stacking and Interposer for Next-Generation AI
- NIST Researchers Develop Photonic Chip Packaging That Can Withstand Extreme Environments
- Rebellions Closes $400 Million Pre-IPO and Launches RebelRack™ and RebelPOD™ to Accelerate Global Expansion
- EdgeCortix Looks To Chiplets For Third-Gen Reconfigurable AI Chip
- Agileo Automation Launches Agil'EDA to Accelerate SEMI EDA Adoption for Semiconductor Equipment OEMs