How Advanced Packaging is Unleashing Possibilities for Edge AI
By Pax Wang, Division Director of Technology Development, UMC
EETimes | November 11, 2025
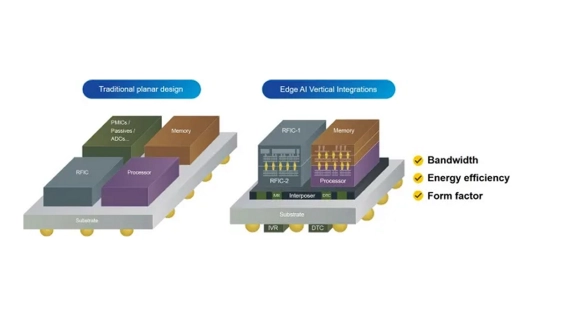
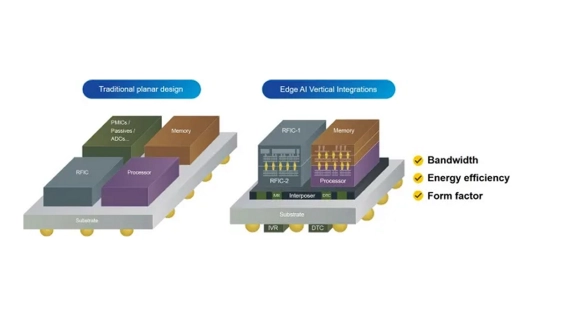 The rapid migration of AI from the cloud to edge devices is fueling explosive growth in edge AI. Sectors like automotive, PCs, robotics, smartphones and surveillance are accelerating adoption, with the number of edge AI devices projected to grow at 17% CAGR to more than 2 billion units by 2030.
The rapid migration of AI from the cloud to edge devices is fueling explosive growth in edge AI. Sectors like automotive, PCs, robotics, smartphones and surveillance are accelerating adoption, with the number of edge AI devices projected to grow at 17% CAGR to more than 2 billion units by 2030.
Compared to cloud AI systems, which deliver up to 10,000 TOPS of computing power and require massive power budgets and high dollar investments, IC design for edge AI applications is completely different. Edge AI devices typically only require 1-50 TOPS with strict power (0.01-1W) and cost ($10-$1,000) constraints. This forces chip designers to address bandwidth, performance, form factor, thermal and cost challenges simultaneously.
From planar to 3D: a turning point in edge AI design
Traditional planar chip architectures are reaching their limits as multimodal AI applications demand more bandwidth and compute resources, increasing chip area and power consumption. To address these challenges, the industry is increasingly embracing 3D vertical stacking, integrating processors, memory and other modules within a single package atop interposers.
The vertical stack approach shortens interconnects, which reduces signal loss and latency, lowers power use and enables more compact devices. The modular design of vertical stacking also improves yield and cost control.
To read the full article, click here
Related Chiplet
- DPIQ Tx PICs
- IMDD Tx PICs
- Near-Packaged Optics (NPO) Chiplet Solution
- High Performance Droplet
- Interconnect Chiplet
Related News
- EdgeCortix Awarded New 3 Billion Yen NEDO Project to Develop Advanced Energy-Efficient AI Chiplet for Edge Inference and Learning
- Marvell Delivers Advanced Packaging Platform for Custom AI Accelerators
- Silicon Box Ships 100M Units, Proves Advanced Panel-Level Packaging Ready for AI, HPC era
- YES Selected to Deliver Full Portfolio of Advanced Packaging Tools for Glass Panel AI and HPC Applications by a Leading AI Infrastructure Supplier
Latest News
- Avicena Launches the World’s First microLED Optical Interconnect Evaluation Kit for AI Infrastructure Innovators
- Lightmatter Achieves Record 1.6 Tbps Per Fiber to Accelerate AI Optical Interconnect
- Arm Positions Neoverse for AI and Telco Networks at MWC
- NVIDIA Compute Architecture Paves the Way for Scale-Up Optical Interconnects; CPO Penetration in AI Data Centers Expected to Rise Steadily
- CEA-Leti and NcodiN Partner to Industrialize 300 mm Silicon Photonics for Bandwidth-Hungry AI Interconnects