ATMPlace: Analytical Thermo-Mechanical-Aware Placement Framework for 2.5D-IC
By Qipan Wang, Tianxiang Zhu, Tianyu Jia , Yibo Lin , Runsheng Wang , Ru Huang
Peking University, China
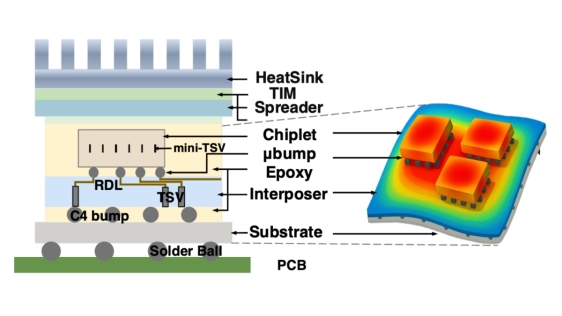
Abstract
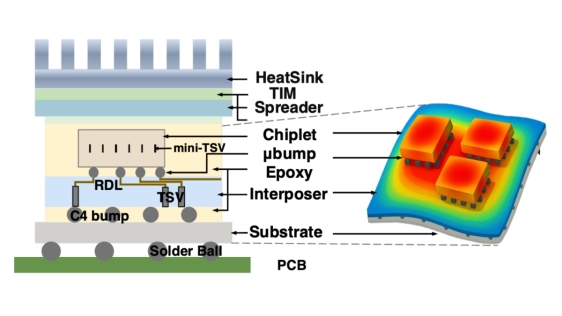 Rising demand in AI and automotive applications is accelerating 2.5D-IC adoption, with multiple chiplets tightly placed to enable high-speed interconnects and heterogeneous integration. As chiplet counts grow, traditional placement tools—limited by poor scalability and reliance on slow simulations—must evolve beyond wirelength minimization to address thermal and mechanical reliability, critical challenges in heterogeneous integration.
Rising demand in AI and automotive applications is accelerating 2.5D-IC adoption, with multiple chiplets tightly placed to enable high-speed interconnects and heterogeneous integration. As chiplet counts grow, traditional placement tools—limited by poor scalability and reliance on slow simulations—must evolve beyond wirelength minimization to address thermal and mechanical reliability, critical challenges in heterogeneous integration.
In this paper, we present ATMPlace, the first analytical placer for 2.5D-ICs that jointly optimizes wirelength, peak temperature, and operational warpage using physics-based compact models. It generates Pareto-optimal placements for systems with dozens of chiplets. Experimental results demonstrate superior performance: 146% and 52% geo-mean wirelength improvement over TAP-2.5D and TACPlace, respectively, with 3–13% lower temperature and 5–27% less warpage — all achieved ∼10× faster. The proposed framework is general and can be extended to enable fast, scalable, and reliable design exploration for next-generation 2.5D systems.
Index Terms — 2.5D-IC; Thermo-Mechanical Optimization; Chiplet Placement; Thermal Warpage
To read the full article, click here
Related Chiplet
- DPIQ Tx PICs
- IMDD Tx PICs
- Near-Packaged Optics (NPO) Chiplet Solution
- High Performance Droplet
- Interconnect Chiplet
Related Technical Papers
- ATPlace2.5D: Analytical Thermal-Aware Chiplet Placement Framework for Large-Scale 2.5D-IC
- Muchisim: A Simulation Framework for Design Exploration of Multi-Chip Manycore Systems
- STAMP-2.5D: Structural and Thermal Aware Methodology for Placement in 2.5D Integration
- LaZagna: An Open-Source Framework for Flexible 3D FPGA Architectural Exploration
Latest Technical Papers
- Spatiotemporal thermal characterization for 3D stacked chiplet systems based on transient thermal simulation
- Interconnect-Aware Logic Resynthesis for Multi-Die FPGAs
- Scope: A Scalable Merged Pipeline Framework for Multi-Chip-Module NN Accelerators
- Scaling Routers with In-Package Optics and High-Bandwidth Memories
- TDPNavigator-Placer: Thermal- and Wirelength-Aware Chiplet Placement in 2.5D Systems Through Multi-Agent Reinforcement Learning